一、 什么叫封裝
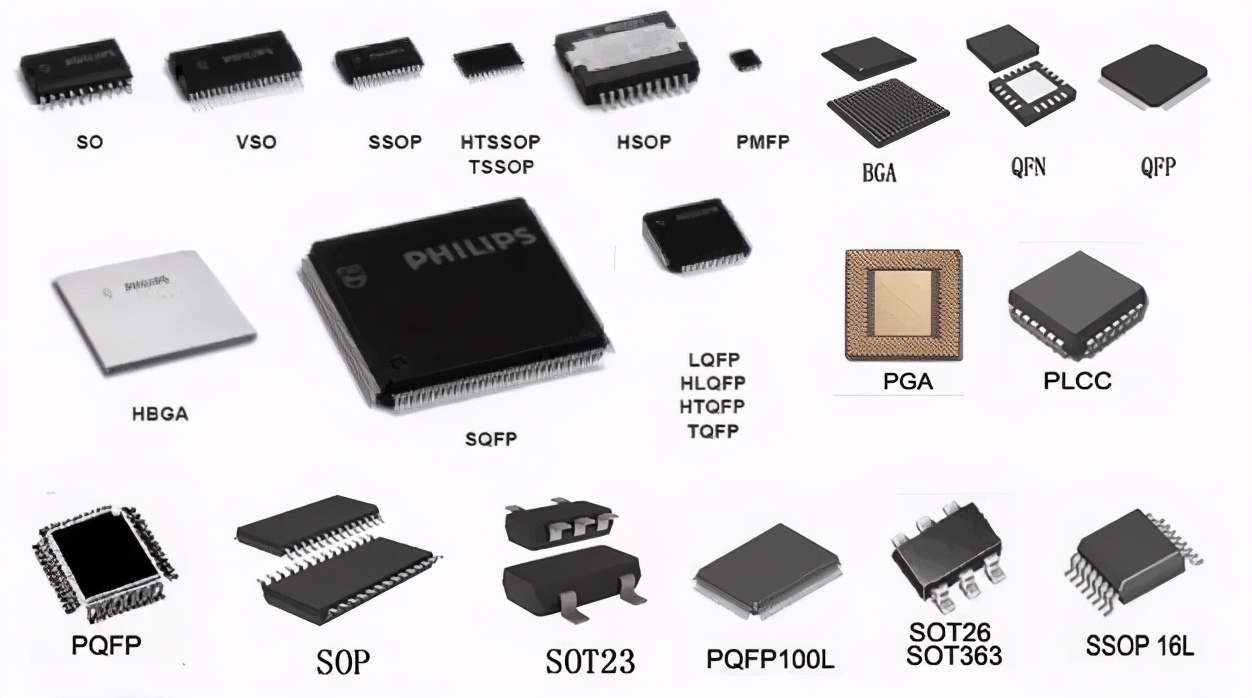
封裝,就是指把硅片上的電路管腳,用導線接引到外部接頭處,以便與其它器件連接。封裝形式是指安裝半導體集成電路芯片用的外殼。它不僅起著安裝、固定、密封、保護芯片及增強電熱性能等方面的作用,而且還通過芯片上的接點用導線連接到封裝外殼的引腳上,這些引腳又通過印刷電路板上的導線與其他器件相連接,從而實現內部芯片與外部電路的連接。因為芯片必須與外界隔離,以防止空氣中的雜質對芯片電路的腐蝕而造成電氣性能下降。
另一方面,封裝后的芯片也更便于安裝和運輸。由于封裝技術的好壞還直接影響到芯片自身性能的發揮和與之連接的PCB(印制電路板)的設計和制造,因此它是至關重要的。
衡量一個芯片封裝技術先進與否的重要指標是芯片面積與封裝面積之比,這個比值越接近1越好。封裝時主要考慮的因素:
1、 芯片面積與封裝面積之比為提高封裝效率,盡量接近1:1;
2、 引腳要盡量短以減少延遲,引腳間的距離盡量遠,以保證互不干擾,提高性能;
3、 基于散熱的要求,封裝越薄越好。
封裝主要分為DIP雙列直插和SMD貼片封裝兩種。從結構方面,封裝經歷了最早期的晶體管TO(如TO-89、TO92)封裝發展到了雙列直插封裝,隨后由 PHILIP公司開發出了SOP小外型封裝,以后逐漸派生出SOJ(J型引腳小外形封裝)、TSOP(薄小外形封裝)、VSOP(甚小外形封裝)、 SSOP(縮小型SOP)、TSSOP(薄的縮小型SOP)及SOT(小外形晶體管)、SOIC(小外形集成電路)等。從材料介質方面,包括金屬、陶瓷、塑料、塑料,目前很多高強度工作條件需求的電路如軍工和宇航級別仍有大量的金屬封裝。
封裝大致經過了如下發展進程:
結構方面:TO->DIP->PLCC->QFP->BGA ->CSP;
材料方面:金屬、陶瓷->陶瓷、塑料->塑料;
引腳形狀:長引線直插->短引線或無引線貼裝->球狀凸點;
裝配方式:通孔插裝->表面組裝->直接安裝。
二、 具體的封裝形式
1、BGA封裝

球形觸點陳列,表面貼裝型封裝之一。在印刷基板的背面按陳列方式制作出球形凸點用以代替引腳,在印刷基板的正面裝配LSI晶元,然后用模壓樹脂或灌封方法進行密封。也稱為凸點陳列載體(PAC)。引腳可超過200,是多引腳LSI用的一種封裝。封裝本體也可做得比QFP(四側引腳扁平封裝)小。例如,引腳中心距為1.5mm的360引腳BGA僅為31mm見方;而引腳中心距為0.5mm的304引腳QFP為40mm見方。而且BGA不用擔心QFP那樣的引腳變形問題。該封裝是美國Motorola公司開發的,首先在攜帶型電督等設備中被采用,今后在美國有可能在個人計算機中普及。最初,BGA的引腳(凸點)中心距為1.5mm,引腳數為225。現在也有一些LSI廠家正在開發500引腳的BGA。BGA的問題是回流焊后的外觀檢查。現在尚不清楚是否有效的外觀檢查方法。有的認為,由于焊接的中心距較大,連接可以看作是穩定的,只能通過功能檢查來處理。美國Motorola公司把用模壓樹脂密封的封裝稱為OMPAC,而把灌封方法密封的封裝稱為GPAC(見OMPAC和GPAC)。
2、BQFP封裝

帶緩沖墊的四側引腳扁平封裝。QFP封裝之一,在封裝本體的四個角設置突起(緩沖墊)以防止在運送過程中引腳發生彎曲變形。美國半導體廠家主要在微處理器和ASIC等電路中采用此封裝。引腳中心距0.635mm,引腳數從84到196左右(見QFP)。
3、SOP/SOIC封裝

SOP 是英文Small Outline Package 的縮寫,即小外形封裝。SOP封裝技術由1968~1969年菲利浦公司開發成功,以后逐漸派生出 SOJ(J型引腳小外形封裝)、TSOP(薄小外形封裝)、VSOP(甚小外形封裝)、SSOP(縮小型SOP)、TSSOP(薄的縮小型SOP)及 SOT(小外形晶體管)、SOIC(小外形集成電路)等。
4、DIP封裝

DIP是英文 Double In-line Package的縮寫,即雙列直插式封裝。插裝型封裝之一,引腳從封裝兩側引出,封裝材料有塑料和陶瓷兩種。DIP是最普及的插裝型封裝,應用范圍包括標準邏輯IC,存貯器LSI,微機電路等。
5、PLCC封裝

PLCC 是英文Plastic Leaded Chip Carrier 的縮寫,即塑封J引線芯片封裝。PLCC封裝方式,外形呈正方形,32腳封裝,四周都有管腳,外形尺寸比DIP封裝小得多。PLCC封裝適合用SMT表面安裝技術在PCB上安裝布線,具有外形尺寸小、可靠性高的優點。
6、TQFP封裝

TQFP 是英文thin quad flat package的縮寫,即薄塑封四角扁平封裝。四邊扁平封裝(TQFP)工藝能有效利用空間,從而降低對印刷電路板空間大小的要求。由于縮小了高度和體積,這種封裝工藝非常適合對空間要求較高的應用,如 PCMCIA 卡和網絡器件。幾乎所有ALTERA的 CPLD/FPGA都有 TQFP 封裝。
7、PQFP封裝

PQFP是英文Plastic Quad Flat Package的縮寫,即塑封四角扁平封裝。PQFP封裝的芯片引腳之間距離很小,管腳很細,一般大規模或超大規模集成電路采用這種封裝形式,其引腳數一般都在100以上。
8、TSOP封裝

TSOP 是英文Thin Small Outline Package的縮寫,即薄型小尺寸封裝。TSOP內存封裝技術的一個典型特征就是在封裝芯片的周圍做出引腳, TSOP適合用SMT技術(表面安裝技術)在PCB(印制電路板)上安裝布線。TSOP封裝外形尺寸時,寄生參數(電流大幅度變化時,引起輸出電壓擾動) 減小,適合高頻應用,操作比較方便,可靠性也比較高。
9、碰焊PGA

表面貼裝型PGA的別稱(見表面貼裝型PGA)。
10、C-(ceramic) 封裝

表示陶瓷封裝的記號。例如,CDIP表示的是陶瓷DIP。是在實際中經常使用的記號。
11、Cerdip封裝

用玻璃密封的陶瓷雙列直插式封裝,用于ECL RAM,DSP(數字信號處理器)等電路。帶有玻璃窗口的Cerdip用于紫外線擦除型EPROM以及內部帶有EPROM的微機電路等。引腳中心距2.54mm,引腳數從8到42。在japon,此封裝表示為DIP-G(G即玻璃密封的意思)。
12、Cerquad封裝

表面貼裝型封裝之一,即用下密封的陶瓷QFP,用于封裝DSP等的邏輯LSI電路。帶有窗口的Cerquad用于封裝EPROM電路。散熱性比塑料QFP好,在自然空冷條件下可容許1. 5~ 2W的功率。但封裝成本比塑料QFP高3~5倍。引腳中心距有1.27mm、0.8mm、0.65mm、 0.5mm、 0.4mm等多種規格。引腳數從32到368。
13、CLCC封裝

帶引腳的陶瓷晶元載體,表面貼裝型封裝之一,引腳從封裝的四個側面引出,呈丁字形。帶有窗口的用于封裝紫外線擦除型EPROM以及帶有EPROM的微機電路等。此封裝也稱為QFJ、QFJ-G(見QFJ)。
14、COB封裝
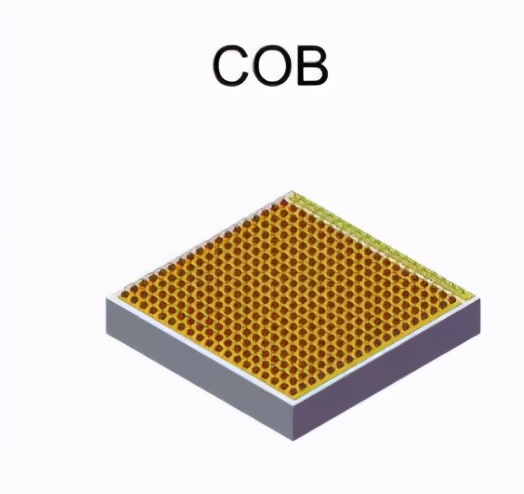
板上晶元封裝,是裸晶元貼裝技術之一,半導體晶元交接貼裝在印刷線路板上,晶元與基板的電氣連接用引線縫合方法實現,晶元與基板的電氣連接用引線縫合方法實現,并用樹脂覆蓋以確保可靠性。雖然COB是最簡單的裸晶元貼裝技術,但它的封裝密度遠不如TAB和倒片焊技術。
15、DFP封裝
雙側引腳扁平封裝。是SOP的別稱(見SOP)。以前曾有此稱法,現在已基本上不用。
16、DIC封裝
陶瓷DIP(含玻璃密封)的別稱(見DIP)。
17、DIL封裝
DIP的別稱(見DIP)。歐洲半導體廠家多用此名稱。
18、DSO封裝
雙側引腳小外形封裝。SOP的別稱(見SOP)。部分半導體廠家采用此名稱。
19、DICP封裝
雙側引腳帶載封裝。TCP(帶載封裝)之一。引腳制作在絕緣帶上并從封裝兩側引出。由于利用的是TAB(自動帶載焊接)技術,封裝外形非常薄。常用于液晶顯示驅動LSI,但多數為定制品。另外,0.5mm厚的存儲器LSI簿形封裝正處于開發階段。在japon,按照EIAJ(japon電子機械工業)會標準規疾,將DICP命名為DTP。
20、FP封裝
扁平封裝。表面貼裝型封裝之一。QFP或SOP(見QFP和SOP)的別稱。部分半導體廠家采用此名稱。
21、FQFP封裝

小引腳中心距QFP。通常指引腳中心距小于0.65mm的QFP(見QFP)。部分導導體廠家采用此名稱。
22、CPAC封裝
美國Motorola公司對BGA的別稱(見BGA)。
23、CQFP封裝

帶保護環的四側引腳扁平封裝。塑料QFP之一,引腳用樹脂保護環掩蔽,以防止彎曲變形。在把LSI組裝在印刷基板上之前,從保護環處切斷引腳并使其成為海鷗翼狀(L形狀)。這種封裝在美國Motorola公司已批量生產。引腳中心距0.5mm,引腳數最多為208左右。
24、H-(with heat sink) 封裝
表示帶散熱器的標記。例如,HSOP表示帶散熱器的SOP。
25、pin grid array封裝
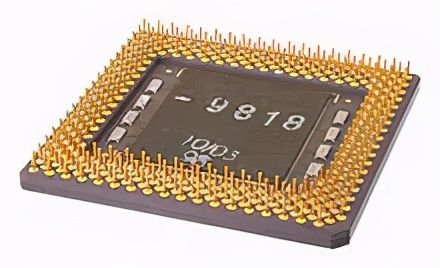
表面貼裝型PGA。通常PGA為插裝型封裝,引腳長約3.4mm。表面貼裝型PGA在封裝的底面有陳列狀的引腳,其長度從1.5mm到2.0mm。貼裝采用與印刷基板碰焊的方法,因而也稱為碰焊PGA。因為引腳中心距只有1.27mm,比插裝型PGA小一半,所以封裝本體可制作得不怎么大,而引腳數比插裝型多(250~528),是大規模邏輯LSI用的封裝。封裝的基材有多層陶瓷基板和玻璃環氧樹脂印刷基數。以多層陶瓷基材制作封裝已經實用化。
三、 國際部分品牌產品的封裝命名規則資料
1、 MAXIM前綴是“MAX”。DALLAS則是以“DS”開頭。
MAX×××或MAX××××
說明:
1、后綴CSA、CWA 其中C表示普通級,S表示表貼,W表示寬體表貼。
2、后綴CWI表示寬體表貼,EEWI寬體工業級表貼,后綴MJA或883為軍級。
3、CPA、BCPI、BCPP、CPP、CCPP、CPE、CPD、ACPA后綴均為普通雙列直插。
舉例MAX202CPE、CPE普通ECPE普通帶抗靜電保護,MAX202EEPE工業級抗靜電保護(-45℃-85℃),說明E指抗靜電保護MAXIM數字排列分類
1字頭 模擬器 2字頭 濾波器 3字頭 多路開關
4字頭 放大器 5字頭 數模轉換器 6字頭 電壓基準
7字頭 電壓轉換 8字頭 復位器 9字頭 比較器
DALLAS命名規則
例如DS1210N.S. DS1225Y-100IND
N=工業級 S=表貼寬體 MCG=DIP封裝 Z=表貼寬體 MNG=DIP工業級
IND=工業級 QCG=PLCC封 Q=QFP
2、AD產品以“AD”、“ADV”居多,也有“OP”或者“REF”、“AMP”、“SMP”、“SSM”、“TMP”、“TMS”等開頭的。
后綴的說明:
1、后綴中J表示民品(0-70℃),N表示普通塑封,后綴中帶R表示表示表貼。
2、后綴中帶D或Q的表示陶封,工業級(45℃-85℃)。后綴中H表示圓帽。
3、后綴中SD或883屬軍品。
例如:JN DIP封裝 JR表貼 JD DIP陶封
3、BB產品命名規則:
前綴ADS模擬器件 后綴U表貼 P是DIP封裝 帶B表示工業級 前綴INA、XTR、PGA等表示高精度運放 后綴U表貼 P代表DIP PA表示高精度
4、INTEL產品命名規則:
N80C196系列都是單片機
前綴:N=PLCC封裝 T=工業級 S=TQFP封裝 P=DIP封裝
KC20主頻 KB主頻 MC代表84引角
舉例:TE28F640J3A-120 閃存 TE=TSOP DA=SSOP E=TSOP
5、以“IS”開頭
比如:IS61C IS61LV 4×表示DRAM 6×表示SRAM 9×表示EEPROM
封裝:PL=PLCC PQ=PQFP T=TSOP TQ=TQFP
6、LINEAR以產品名稱為前綴
LTC1051CS CS表示表貼
LTC1051CN8 **表示*IP封裝8腳
7、IDT的產品一般都是IDT開頭的
后綴的說明:
1、后綴中TP屬窄體DIP
2、后綴中P 屬寬體DIP
3、后綴中J 屬PLCC
比如:IDT7134SA55P 是DIP封裝
IDT7132SA55J 是PLCC
IDT7206L25TP 是DIP
8、NS的產品部分以LM 、LF開頭的
LM324N 3字頭代表民品 帶N圓帽
LM224N 2字頭代表工業級 帶J陶封
LM124J 1字頭代表軍品 帶N塑封
9、 HYNIX
封裝:DP代表DIP封裝 DG代表SOP封裝 DT代表TSOP封裝。

